底部填充胶的各种问题解读
底部填充胶(underfill)在实际应用过程中,会遇到各种各样的问题,包括从柔性基板上的最小芯片到最大的BGA封装,比如填充出现空洞和气隙,比如点胶时出现的各种问题等。今天与大家分享underfill底部填充胶点胶时易出现的问题:
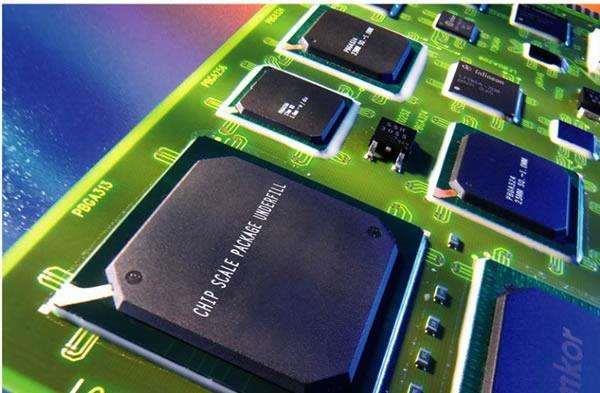
那么,如何选用底部填充胶呢?为大家整理了相关资料提供参考:
点胶坍塌:
点胶坍塌是和点胶点高相反的情况,整个元器件向点胶部位倾斜。
点胶坍塌的因素就是底部填充胶过稀导致流动性太强,点胶量较少等,当然还有底部填充胶变质,例如储存条件不好,过期等因素。
2.点胶点高:
一般的underfill点胶正常来说是一团团在那里,有点类似于牙膏挤压出来的状态。而点胶点高就是指这一团底部填充胶的高度过高,这个过高是以整个元器件为标准的,高度过高就会产生拉丝现象。
点胶点过高的原因有:底部填充胶过于粘稠,缺少良好的流动性。点胶量过多,点胶时推力大,针口较粗等。
3. 点胶没有点到位:
类似于锡膏的虚焊、空焊。针筒未出胶等因素造成的。
KY底部填充胶,高流动性、高纯度单组份灌封材料,能够形成均匀且无空洞的底部填充层,对极细间距的部件快速填充,快速固化,通过消除由焊接材料引起的应力,提高元器件的可靠性和机械性能。
良好的底部填充胶,需具有较长的储存期,解冻后较长的使用寿命。一般来说,BGA/CSP填充胶的有效期不低于六个月(储存条件:-20°C~5℃),在室温下(25℃)的有效使用寿命需不低于48小时。有效使用期是指,胶水从冷冻条件下取出后在一定的点胶速度下可保证点胶量的连续性及一致性的稳定时间,期间胶水的粘度增大不能超过10%。微小形球径的WLP和FC器件,胶材的有效使用期相比于大间距的BGA/CSP器件通常要短一些,因胶水的粘度需控制在1000mpa.s以下,以利于填充的效率。使用期短的胶水须采用容量较小的针筒包装,反之可采用容量较大的桶装;使用寿命越短包装应该稍小,比如用于倒装芯片的胶水容量不要超过50ml,以便在短时间内用完。大规模生产中,使用期长的胶水可能会用到1000ml的大容量桶装,为此需要分装成小容量针筒以便点胶作业,在分装或更换针筒要避免空气混入。此外,使用期短的胶水易硬化堵塞针头,每次生产完需尽快清洗针管和其它沾胶部件。
此外,表面张力和温差是底部填充产生毛细流动的二个主要因素,由于热力及表面张力的驱动,填充材料才能自动流至芯片底部。另外,填充材料都会界定最小的填充间隙,在选择时需要考虑产品的最小间隙是否满足要求
上一条: Reflow profile三种类型
下一条: 底部填充胶返修流程

